常用IC封装技术说明
常用IC封装技术介绍
1、BGA(ballgridarray)
球形触点陈列,表面贴装型封装之一。在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI芯片,然后用模压树脂或灌封方法进行密封。也称为凸点陈列载体(PAC)。引脚可超过200,是多引脚LSI用的一种封装。封装本体也可做得比QFP(四侧引脚扁平封装)小。例如,引脚中心距为1.5mm的360引脚BGA仅为31mm见方;而引脚中心距为0.5mm的304引脚QFP为40mm见方。而且BGA不用担心QFP那样的引脚变形问题。该封装是美国Motorola公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。最初,BGA的引脚(凸点)中心距为1.5mm,引脚数为225。现在也有一些LSI厂家正在开发500引脚的BGA。BGA的问题是回流焊后的外观检查。现在尚不清楚是否有效的外观检查方法。有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。美国Motorola公司把用模压树脂密封的封装称为OMPAC,而把灌封方法密封的封装称为GPAC(见OMPAC和GPAC)。
2、BQFP(quadflatpackagewithbumper)
带缓冲垫的四侧引脚扁平封装。QFP封装之一,在封装本体的四个角设置突起(缓冲垫)以防止在运送过程中引脚发生弯曲变形。美国半导体厂家主要在微处理器和ASIC等电路中采用此封装。引脚中心距0.635mm,引脚数从84到196左右(见QFP)。
3、碰焊PGA(buttjointpingridarray)
表面贴装型PGA的别称(见表面贴装型PGA)。
4、C-(ceramic)
表示陶瓷封装的记号。例如,CDIP表示的是陶瓷DIP。是在实际中经常使用的记号。
5、Cerdip
用玻璃密封的陶瓷双列直插式封装,用于ECLRAM,DSP(数字信号处理器)等电路。带有玻璃窗口的Cerdip用于紫外线擦除型EPROM以及内部带有EPROM的微机电路等。引脚中心距2.54mm,引脚数从8到42。在japon,此封装表示为DIP-G(G即玻璃密封的意思)。
6、Cerquad
表面贴装型封装之一,即用下密封的陶瓷QFP,用于封装DSP等的逻辑LSI电路。带有窗口的Cerquad用于封装EPROM电路。散热性比塑料QFP好,在自然空冷条件下可容许1.5~2W的功率。但封装成本比塑料QFP高3~5倍。引脚中心距有1.27mm、0.8mm、0.65mm、0.5mm、0.4mm等多种规格。引脚数从32到368。
7、CLCC(ceramicleadedchipcarrier)
带引脚的陶瓷芯片载体,表面贴装型封装之一,引脚从封装的四个侧面引出,呈丁字形。带有窗口的用于封装紫外线擦除型EPROM以及带有EPROM的微机电路等。此封装也称为QFJ、QFJ-G(见QFJ)。
8、COB(chiponboard)
板上芯片封装,是裸芯片贴装技术之一,半导体芯片交接贴装在印刷线路板上,芯片与基板的电气连接用引线缝合方法实现,芯片与基板的电气连接用引线缝合方法实现,并用树脂覆盖以确保可靠性。虽然COB是最简单的裸芯片贴装技术,但它的封装密度远不如TAB和倒片焊技术。
9、DFP(dualflatpackage)
双侧引脚扁平封装。是SOP的别称(见SOP)。以前曾有此称法,现在已基本上不用。
10、DIC(dualin-lineceramicpackage)
陶瓷DIP(含玻璃密封)的别称(见DIP)。
11、DIL(dualin-line)
DIP的别称(见DIP)。欧洲半导体厂家多用此名称。
12、DIP(dualin-linepackage)
双列直插式封装。插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。DIP是最普及的插装型封装,应用范围包括标准逻辑IC,存贮器LSI,微机电路等。引脚中心距2.54mm,引脚数从6到64。封装宽度通常为15.2mm。有的把宽度为7.52mm和10.16mm的封装分别称为skinnyDIP和slimDIP(窄体型DIP)。但多数情况下并不加区分,只简单地统称为DIP。另外,用低熔点玻璃密封的陶瓷DIP也称为cerdip(见cerdip)。
13、DSO(dualsmallout-lint)
双侧引脚小外形封装。SOP的别称(见SOP)。部分半导体厂家采用此名称。
14、DICP(dualtapecarrierpackage)
双侧引脚带载封装。TCP(带载封装)之一。引脚制作在绝缘带上并从封装两侧引出。由于利用的是TAB(自动带载焊接)技术,封装外形非常薄。常用于液晶显示驱动LSI,但多数为定制品。另外,0.5mm厚的存储器LSI簿形封装正处于开发阶段。在japon,按照EIAJ(japon电子机械工业)会标准规定,将DICP命名为DTP。
15、DIP(dualtapecarrierpackage)
同上。japon电子机械工业会标准对DTCP的命名(见DTCP)。
16、FP(flatpackage)
扁平封装。表面贴装型封装之一。QFP或SOP(见QFP和SOP)的别称。部分半导体厂家采用此名称。
17、flip-chip
倒焊芯片。裸芯片封装技术之一,在LSI芯片的电极区制作好金属凸点,然后把金属凸点与印刷基板上的电极区进行压焊连接。封装的占有面积基本上与芯片尺寸相同。是所有封装技术中体积最小、最薄的一种。但如果基板的热膨胀系数与LSI芯片不同,就会在接合处产生反应,从而影响连接的可靠性。因此必须用树脂来加固LSI芯片,并使用热膨胀系数基本相同的基板材料。
18、FQFP(finepitchquadflatpackage)
小引脚中心距QFP。通常指引脚中心距小于0.65mm的QFP(见QFP)。部分导导体厂家采用此名称。
19、CPAC(globetoppadarraycarrier)
美国Motorola公司对BGA的别称(见BGA)。
20、CQFP(quadfiatpackagewithguardring)
带保护环的四侧引脚扁平封装。塑料QFP之一,引脚用树脂保护环掩蔽,以防止弯曲变形。在把LSI组装在印刷基板上之前,从保护环处切断引脚并使其成为海鸥翼状(L形状)。这种封装在美国Motorola公司已批量生产。引脚中心距0.5mm,引脚数最多为208左右。
21、H-(withheatsink)
表示带散热器的标记。例如,HSOP表示带散热器的SOP。
22、pingridarray(surfacemounttype)
表面贴装型PGA。通常PGA为插装型封装,引脚长约3.4mm。表面贴装型PGA在封装的底面有陈列状的引脚,其长度从1.5mm到2.0mm。贴装采用与印刷基板碰焊的方法,因而也称为碰焊PGA。因为引脚中心距只有1.27mm,比插装型PGA小一半,所以封装本体可制作得不怎么大,而引脚数比插装型多(250~528),是大规模逻辑LSI用的封装。封装的基材有多层陶瓷基板和玻璃环氧树脂印刷基数。以多层陶瓷基材制作封装已经实用化。
23、JLCC(J-leadedchipcarrier)
J形引脚芯片载体。指带窗口CLCC和带窗口的陶瓷QFJ的别称(见CLCC和QFJ)。部分半导体厂家采用的名称。
24、LCC(Leadlesschipcarrier)
无引脚芯片载体。指陶瓷基板的四个侧面只有电极接触而无引脚的表面贴装型封装。是高速和高频IC用封装,也称为陶瓷QFN或QFN-C(见QFN)。
25、LGA(landgridarray)
触点陈列封装。即在底面制作有阵列状态坦电极触点的封装。装配时插入插座即可。现已实用的有227触点(1.27mm中心距)和447触点(2.54mm中心距)的陶瓷LGA,应用于高速逻辑LSI电路。LGA与QFP相比,能够以比较小的封装容纳更多的输入输出引脚。另外,由于引线的阻抗小,对于高速LSI是很适用的。但由于插座制作复杂,成本高,现在基本上不怎么使用。预计今后对其需求会有所增加。
26、LOC(leadonchip)
芯片上引线封装。LSI封装技术之一,引线框架的前端处于芯片上方的一种结构,芯片的中心附近制作有凸焊点,用引线缝合进行电气连接。与原来把引线框架布置在芯片侧面附近的结构相比,在相同大小的封装中容纳的芯片达1mm左右宽度。
27、LQFP(lowprofilequadflatpackage)
薄型QFP。指封装本体厚度为1.4mm的QFP,是japon电子机械工业会根据制定的新QFP外形规格所用的名称。
28、L-QUAD
陶瓷QFP之一。封装基板用氮化铝,基导热率比氧化铝高7~8倍,具有较好的散热性。封装的框架用氧化铝,芯片用灌封法密封,从而抑制了成本。是为逻辑LSI开发的一种封装,在自然空冷条件下可容许W3的功率。现已开发出了208引脚(0.5mm中心距)和160引脚(0.65mm中心距)的LSI逻辑用封装,并于1993年10月开始投入批量生产。
29、MCM(multi-chipmodule)
多芯片组件。将多块半导体裸芯片组装在一块布线基板上的一种封装。根据基板材料可分为MCM-L,MCM-C和MCM-D三大类。MCM-L是使用通常的玻璃环氧树脂多层印刷基板的组件。布线密度不怎么高,成本较低。MCM-C是用厚膜技术形成多层布线,以陶瓷(氧化铝或玻璃陶瓷)作为基板的组件,与使用多层陶瓷基板的厚膜混合IC类似。两者无明显差别。布线密度高于MCM-L。MCM-D是用薄膜技术形成多层布线,以陶瓷(氧化铝或氮化铝)或Si、Al作为基板的组件。布线密谋在三种组件中是最高的,但成本也高。
30、MFP(miniflatpackage)
小形扁平封装。塑料SOP或SSOP的别称(见SOP和SSOP)。部分半导体厂家采用的名称。
31、MQFP(metricquadflatpackage)
按照JEDEC(美国联合电子设备委员会)标准对QFP进行的一种分类。指引脚中心距为0.65mm、本体厚度为3.8mm~2.0mm的标准QFP(见QFP)。
32、MQUAD(metalquad)
美国Olin公司开发的一种QFP封装。基板与封盖均采用铝材,用粘合剂密封。在自然空冷条件下可容许2.5W~2.8W的功率。japon新光电气工业公司于1993年获得特许开始生产。
33、MSP(minisquarepackage)
QFI的别称(见QFI),在开发初期多称为MSP。QFI是japon电子机械工业会规定的名称。
34、OPMAC(overmoldedpadarraycarrier)
模压树脂密封凸点陈列载体。美国Motorola公司对模压树脂密封BGA采用的名称(见BGA)。
35、P-(plastic)
表示塑料封装的记号。如PDIP表示塑料DIP。
36、PAC(padarraycarrier)
凸点陈列载体,BGA的别称(见BGA)
37、PCLP(printedcircuitboardleadlesspackage)
印刷电路板无引线封装。japon富士通公司对塑料QFN(塑料LCC)采用的名称(见QFN)。引脚中心距有0.55mm和0.4mm两种规格。目前正处于开发阶段。
38、PFPF(plasticflatpackage)
塑料扁平封装。塑料QFP的别称(见QFP)。部分LSI厂家采用的名称。
39、PGA(pingridarray)
陈列引脚封装。插装型封装之一,其底面的垂直引脚呈陈列状排列。封装基材基本上都采用多层陶瓷基板。在未专门表示出材料名称的情况下,多数为陶瓷PGA,用于高速大规模逻辑LSI电路。成本较高。引脚中心距通常为2.54mm,引脚数从64到447左右。了为降低成本,封装基材可用玻璃环氧树脂印刷基板代替。也有64~256引脚的塑料PGA。另外,还有一种引脚中心距为1.27mm的短引脚表面贴装型PGA(碰焊PGA)。(见表面贴装型PGA)。
40、piggyback
驮载封装。指配有插座的陶瓷封装,形关与DIP、QFP、QFN相似。在开发带有微机的设备时用于评价程序确认操作。例如,将EPROM插入插座进行调试。这种封装基本上都是定制品,市场上不怎么流通。
41、PLCC(plasticleadedchip carrier)
带引线的塑料芯片载体。表面贴装型封装之一。引脚从封装的四个侧面引出,呈丁字形,是塑料制品。美国德克萨斯仪器公司首先在64k位DRAM和256kDRAM中采用,现在已经普及用于逻辑LSI、DLD(或程逻辑器件)等电路。引脚中心距1.27mm,引脚数从18到84。J形引脚不易变形,比QFP容易操作,但焊接后的外观检查较为困难。PLCC与LCC(也称QFN)相似。以前,两者的区别仅在于前者用塑料,后者用陶瓷。但现在已经出现用陶瓷制作的J形引脚封装和用塑料制作的无引脚封装(标记为塑料LCC、PCLP、P-LCC等),已经无法分辨。为此,japon电子机械工业会于1988年决定,把从四侧引出J形引脚的封装称为QFJ,把在四侧带有电极凸点的封装称为QFN(见QFJ和QFN)。
42、P-LCC(plasticteadlesschipcarrier)(plasticleadedchipcurrier)
有时候是塑料QFJ的别称,有时候是QFN(塑料LCC)的别称(见QFJ和QFN)。部分LSI厂家用PLCC表示带引线封装,用P-LCC表示无引线封装,以示区别。
43、QFH(quadflathighpackage)
四侧引脚厚体扁平封装。塑料QFP的一种,为了防止封装本体断裂,QFP本体制作得较厚(见QFP)。部分半导体厂家采用的名称。
44、QFI(quadflatI-leadedpackgac)
四侧I形引脚扁平封装。表面贴装型封装之一。引脚从封装四个侧面引出,向下呈I字。也称为MSP(见MSP)。贴装与印刷基板进行碰焊连接。由于引脚无突出部分,贴装占有面积小于QFP。日立制作所为视频模拟IC开发并使用了这种封装。此外,japon的Motorola公司的PLLIC也采用了此种封装。引脚中心距1.27mm,引脚数从18于68。
45、QFJ(quadflatJ-leadedpackage)
四侧J形引脚扁平封装。表面贴装封装之一。引脚从封装四个侧面引出,向下呈J字形。是japon电子机械工业会规定的名称。引脚中心距1.27mm。
材料有塑料和陶瓷两种。塑料QFJ多数情况称为PLCC(见PLCC),用于微机、门陈列、DRAM、ASSP、OTP等电路。引脚数从18至84。陶瓷QFJ也称为CLCC、JLCC(见CLCC)。带窗口的封装用于紫外线擦除型EPROM以及带有EPROM的微机芯片电路。引脚数从32至84
46、QFN(quadflatnon-leadedpackage)
四侧无引脚扁平封装。表面贴装型封装之一。现在多称为LCC。QFN是japon电子机械工业会规定的名称。封装四侧配置有电极触点,由于无引脚,贴装占有面积比QFP小,高度比QFP低。但是,当印刷基板与封装之间产生应力时,在电极接触处就不能得到缓解。因此电极触点难于作到QFP的引脚那样多,一般从14到100左右。材料有陶瓷和塑料两种。当有LCC标记时基本上都是陶瓷QFN。电极触点中心距1.27mm。
塑料QFN是以玻璃环氧树脂印刷基板基材的一种低成本封装。电极触点中心距除1.27mm外,还有0.65mm和0.5mm两种。这种封装也称为塑料LCC、PCLC、P-LCC等。
47、QFP(quadflatpackage)
四侧引脚扁平封装。表面贴装型封装之一,引脚从四个侧面引出呈海鸥翼(L)型。基材有陶瓷、金属和塑料三种。从数量上看,塑料封装占绝大部分。当没有特别表示出材料时,多数情况为塑料QFP。塑料QFP是最普及的多引脚LSI封装。不仅用于微处理器,门陈列等数字逻辑LSI电路,而且也用于VTR信号处理、音响信号处理等模拟LSI电路。引脚中心距有1.0mm、0.8mm、0.65mm、0.5mm、0.4mm、0.3mm等多种规格。0.65mm中心距规格中最多引脚数为304。
japon将引脚中心距小于0.65mm的QFP称为QFP(FP)。但现在japon电子机械工业会对QFP的外形规格进行了重新评价。在引脚中心距上不加区别,而是根据封装本体厚度分为QFP(2.0mm~3.6mm厚)、LQFP(1.4mm厚)和TQFP(1.0mm厚)三种。
另外,有的LSI厂家把引脚中心距为0.5mm的QFP专门称为收缩型QFP或SQFP、VQFP。但有的厂家把引脚中心距为0.65mm及0.4mm的QFP也称为SQFP,至使名称稍有一些混乱。QFP的缺点是,当引脚中心距小于0.65mm时,引脚容易弯曲。为了防止引脚变形,现已出现了几种改进的QFP品种。如封装的四个角带有树指缓冲垫的BQFP(见BQFP);带树脂保护环覆盖引脚前端的GQFP(见GQFP);在封装本体里设置测试凸点、放在防止引脚变形的专用夹具里就可进行测试的TPQFP(见TPQFP)。在逻辑LSI方面,不少开发品和高可靠品都封装在多层陶瓷QFP里。引脚中心距最小为0.4mm、引脚数最多为348的产品也已问世。此外,也有用玻璃密封的陶瓷QFP(见Gerqad)。
48、QFP(FP)(QFPfinepitch)
小中心距QFP。japon电子机械工业会标准所规定的名称。指引脚中心距为0.55mm、0.4mm、0.3mm等小于0.65mm的QFP(见QFP)。
49、QIC(quadin-lineceramicpackage)
陶瓷QFP的别称。部分半导体厂家采用的名称(见QFP、Cerquad)。
50、QIP(quadin-lineplasticpackage)
塑料QFP的别称。部分半导体厂家采用的名称(见QFP)。
51、QTCP(quadtapecarrierpackage)
四侧引脚带载封装。TCP封装之一,在绝缘带上形成引脚并从封装四个侧面引出。是利用TAB技术的薄型封装(见TAB、TCP)。
52、QTP(quadtapecarrierpackage)
四侧引脚带载封装。japon电子机械工业会于1993年4月对QTCP所制定的外形规格所用的名称(见TCP)。
53、QUIL(quadin-line)
QUIP的别称(见QUIP)。
54、QUIP(quadin-linepackage)
四列引脚直插式封装。引脚从封装两个侧面引出,每隔一根交错向下弯曲成四列。引脚中心距1.27mm,当插入印刷基板时,插入中心距就变成2.5mm。因此可用于标准印刷线路板。是比标准DIP更小的一种封装。japon电气公司在台式计算机和家电产品等的微机芯片中采用了些种封装。材料有陶瓷和塑料两种。引脚数64。
55、SDIP(shrinkdualin-linepackage)
收缩型DIP。插装型封装之一,形状与DIP相同,但引脚中心距(1.778mm)小于DIP(2.54mm),因而得此称呼。引脚数从14到90。也有称为SH-DIP的。材料有陶瓷和塑料两种。
56、SH-DIP(shrinkdualin-linepackage)
同SDIP。部分半导体厂家采用的名称。
57、SIL(singlein-line)
SIP的别称(见SIP)。欧洲半导体厂家多采用SIL这个名称。
58、SIMM(singlein-linememorymodule)
单列存贮器组件。只在印刷基板的一个侧面附近配有电极的存贮器组件。通常指插入插座的组件。标准SIMM有中心距为2.54mm的30电极和中心距为1.27mm的72电极两种规格。在印刷基板的单面或双面装有用SOJ封装的1兆位及4兆位DRAM的SIMM已经在个人计算机、工作站等设备中获得广泛应用。至少有30~40%的DRAM都装配在SIMM里。
59、SIP(singlein-linepackage)
单列直插式封装。引脚从封装一个侧面引出,排列成一条直线。当装配到印刷基板上时封装呈侧立状。引脚中心距通常为2.54mm,引脚数从2至23,多数为定制产品。封装的形状各异。也有的把形状与ZIP相同的封装称为SIP。
60、SK-DIP(skinnydualin-linepackage)
DIP的一种。指宽度为7.62mm、引脚中心距为2.54mm的窄体DIP。通常统称为DIP(见DIP)。
61、SL-DIP(slimdualin-linepackage)
DIP的一种。指宽度为10.16mm,引脚中心距为2.54mm的窄体DIP。通常统称为DIP。
62、SMD(surfacemountdevices)
表面贴装器件。偶而,有的半导体厂家把SOP归为SMD(见SOP)。
63、SO(smallout-line)
SOP的别称。世界上很多半导体厂家都采用此别称。(见SOP)
64、SOI(smallout-lineI-leadedpackage)
I形引脚小外型封装。表面贴装型封装之一。引脚从封装双侧引出向下呈I字形,中心距1.27mm。贴装占有面积小于SOP。日立公司在模拟IC(电机驱动用IC)中采用了此封装。引脚数26。
65、SOIC(smallout-lineintegratedcircuit)
SOP的别称(见SOP)。国外有许多半导体厂家采用此名称。
66、SOJ(SmallOut-LineJ-LeadedPackage)
J形引脚小外型封装。表面贴装型封装之一。引脚从封装两侧引出向下呈J字形,故此得名。通常为塑料制品,多数用于DRAM和SRAM等存储器LSI电路,但绝大部分是DRAM。用SOJ封装的DRAM器件很多都装配在SIMM上。引脚中心距1.27mm,引脚数从20至40(见SIMM)。
67、SQL(SmallOut-LineL-leadedpackage)
按照JEDEC(美国联合电子设备工程委员会)标准对SOP所采用的名称(见SOP)。
68、SONF(SmallOut-LineNon-Fin)
无散热片的SOP。与通常的SOP相同。为了在功率IC封装中表示无散热片的区别,有意增添了NF(non-fin)标记。部分半导体厂家采用的名称(见SOP)。
69、SOF(smallOut-Linepackage)
小外形封装。表面贴装型封装之一,引脚从封装两侧引出呈海鸥翼状(L字形)。材料有塑料和陶瓷两种。另外也叫SOL和DFP。SOP除了用于存储器LSI外,也广泛用于规模不太大的ASSP等电路。在输入输出端子不超过10~40的领域,SOP是普及最广的表面贴装封装。引脚中心距1.27mm,引脚数从8~44。
另外,引脚中心距小于1.27mm的SOP也称为SSOP;装配高度不到1.27mm的SOP也称为TSOP(见SSOP、TSOP)。还有一种带有散热片的SOP。
70、SOW(SmallOutlinePackage(Wide-Jype))
宽体SOP。部分半导体厂家采用的



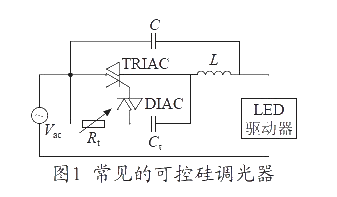

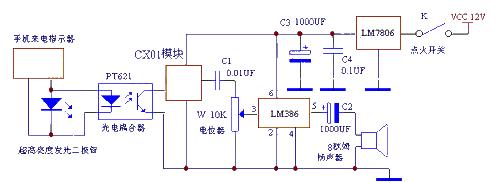
评论