电子元件立体封装技术 1
最近几年应用现金支付功能、行动电话数字电视(One Segment)收讯功能、GPS定位功能、触感式电子游乐器功能的携带型数字电子终端机器急遽高性能化,这类电子机器大多要求轻巧、小型、薄型化,然而构成电子电路的玻璃环氧树脂基板,与可挠曲基板等印刷布线基板,只允许在上、下面作平面性电子组件封装,面临高功能化市场要求时,传统封装技术已经出现小型、薄型化的物理极限。
在此背景下射出成形整合组件(MID: Molded Interconnect Devices,以下简称为整合成形立体基板)的应用与发展,立即成为全球注目的焦点。
整合成形立体基板(MID)是在树脂材质射出成形组件表面制作铜箔图案,接着将电子组件高密度封装在铜箔图案表面,形成所谓多次元封装模块,大幅缩减电子电路的外形尺寸,有效提高封装精度。
发展经纬
如图1所示整合成形立体基板(MID)利用模具制作陶瓷或是树脂射出成形组件,接着在成型组件表面制作铜箔图案,由于此机构整合机械特性与印刷电路导线基板电气特性,因此可以削减功能复合化与电子组件小型化时,引发的模块组件数量以及电路模块基板组立的作业时数。
传统印刷电路导线基板通常是在上、下或是基板内部封装电子组件,如果改用整合成形立体基板(MID),就可以在理想位置高精度、多次元封装电子组件,同时还可以有效抑制电气性噪讯对周围环境的影响。
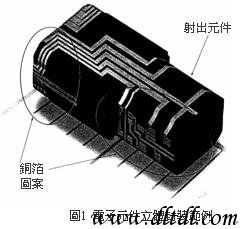
整合成形立体基板(MID)对医疗机器的小型化也很有贡献,例如鼻腔型医疗用相机、一次丢弃型吞服胶囊相机,都可以减轻病患就诊时的痛苦。
一般认为未来高辉度LED照明市场,与车用照明灯具可望大幅成长,高辉度LED封装要求高散热、高反射、长寿命等基本特性。
由于整合成形立体基板(MID)可以在高散热陶瓷表面制作图案,具有极高的形状自由度,因此它的未来应用备受高度期待。
目前已经实用化的人体传感器,透过多次元电子组件的封装实现小型化宿愿,未来如果应用在其它领域,例如应用在感测人体的点灯照明系统,可望获得减碳、省能源等多重效果。
随着汽车电子化的发展,各种传感器的使用数量急遽增加,典型的加速、温/湿度、压力传感器模块,透过整合成形立体基板(MID)的导入,同样可以实现小型化等目标。
行动电话使用的电子组件之中,相机模块是最不易小型化的光学电子组件,不过市场对行动电话用相机模块的超薄型化、高画素化却越来越强烈,透过整合成形立体基板(MID)的使用,未来行动电话的超薄型、高画素化、高功能化,势必出现全新的风貌。 -------------------------電子園


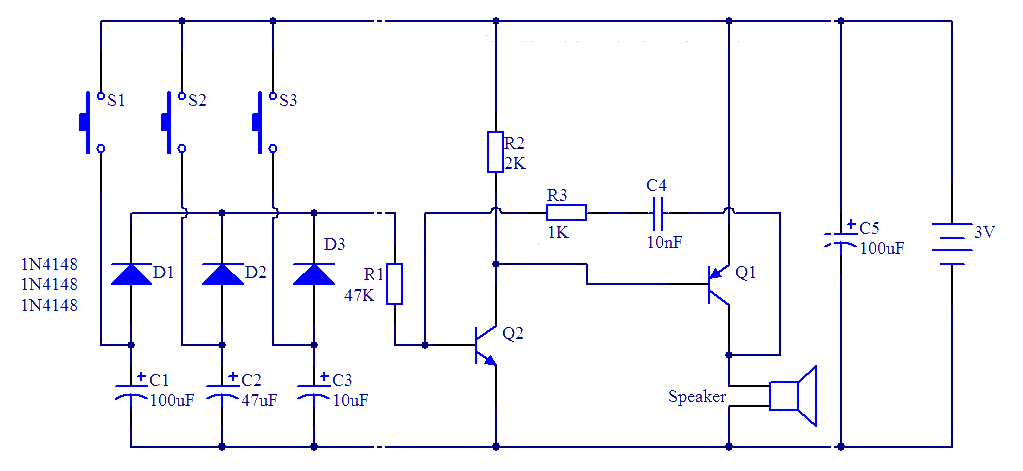



评论